Лабораторная работа № 2.
Цель работы
1. Изучение закономерностей процесса диффузии
2. Изучение влияния различных факторов на скорость диффузии.
3. Расчет профиля распределения примеси и глубины залегания p-n перехода при различных технологических режимах.
Введение
Диффузия представляет собой процесс движения примесных атомов в кристаллической решетке. В отличие от диффузии в газовой фазе перемещение атомов в кристалле осуществляется скачками. Атомы кристалла образуют пространственную периодическую структуру. Примесный атом, перемещаясь по кристаллу, постоянно перескакивает из одного устойчивого состояния в другое. Для того чтобы осуществился такой перескок, необходимо, чтобы атом получил от кристаллической решетки энергию, достаточную для преодоления потенциального барьера, удерживающего атом в устойчивом состоянии. Кроме этого, необходимо также, чтобы конечный пункт перескока примесного атома был свободен. Высота потенциального барьера, называемого энергией активации диффузии, для большинства материалов имеет значение 1 - 4 эВ, а расстояние между соседними потенциальными барьерами соответствует постоянной решетки и примерно равно 0,1 - 0,3 нм.
Примесные атомы в кристалле могут перемещаться либо по вакансиям (свободным узлам кристаллической решетки), либо по междоузлиям. Соответственно этому различают два основных механизма диффузии: диффузия по вакансиям (диффузия замещения) и диффузия по междоузлиям (диффузия внедрения). Диффузия по междоузлиям происходит в сотни тысяч раз быстрее, чем диффузия по вакансиям. Это объясняется тем, что при диффузии по вакансиям необходимым условием является наличие вакансии вблизи диффундирующего атома, а это представляет собой относительно редкое событие, поскольку концентрация вакансий в кристалле невелика. При диффузии по междоузлиям такое условие несущественно, поскольку большинство междоузлий свободно. Реально имеет место комбинация этих двух механизмов, но один из них обычно преобладает. Примесные атомы III и V групп в кремнии диффундируют, как правило, по вакансиям, а атомы I и VIII – по междоузлиям.
Закономерности диффузионных процессов описываются законами Фика, которые для одномерного случая имеют вид:
 - 1-й закон Фика,
- 1-й закон Фика,
 - 2-й закон Фика.
- 2-й закон Фика.
Здесь j – плотность потока атомов диффузанта; c – концентрация примеси; D – коэффициент диффузии примеси, зависящей от температуры:
 ,
,
где Ea – энергия активации диффузии; D0 – коэффициент диффузии при физически бесконечной температуре, т. е. при  . Значение энергии активации Ea, коэффициента диффузии D0, приведены в таблице. Если коэффициент диффузии не зависит от координаты, то 2-й закон Фика, называемый уравнением диффузии, примет вид:
. Значение энергии активации Ea, коэффициента диффузии D0, приведены в таблице. Если коэффициент диффузии не зависит от координаты, то 2-й закон Фика, называемый уравнением диффузии, примет вид:
 .
.
Решение уравнения диффузии позволяет рассчитать зависимость  и тем самым определить профиль распределения примеси по глубине в различные моменты времени. Результат решения зависит от граничных условий. С практической точки зрения интерес представляют два случая, отличающихся заданием граничных условий: диффузия из неограниченного источника и диффузия из ограниченного источника.
и тем самым определить профиль распределения примеси по глубине в различные моменты времени. Результат решения зависит от граничных условий. С практической точки зрения интерес представляют два случая, отличающихся заданием граничных условий: диффузия из неограниченного источника и диффузия из ограниченного источника.
Случай 1. Диффузия из неограниченного источника. Граничные условия в этом случае имеют вид:
 = const;
= const;  ,
,
где  - концентрация примеси в приповерхностном слое полупроводника.
- концентрация примеси в приповерхностном слое полупроводника.
Решением уравнения диффузии в этом случае будет функция, описываемая выражением:
 ,
,
где  - дополнительная функция ошибок, равная по определению:
- дополнительная функция ошибок, равная по определению:
 .
.
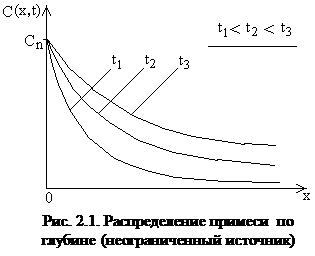 Значения этой функции протабулированы. Профили распределения примеси по глубине для этого случая представлены на рис. 2.1. Здесь же пунктиром показана концентрация исходной примеси, противоположной по типу вводимой примеси.
Значения этой функции протабулированы. Профили распределения примеси по глубине для этого случая представлены на рис. 2.1. Здесь же пунктиром показана концентрация исходной примеси, противоположной по типу вводимой примеси.
Диффузия из неограниченного источника обычно соответствует первому этапу диффузии, задачей которого является введение в кристалл определенного количества примеси (так называемая загонка примеси), которое определяется дозой легирования N. Доза легирования N по определению равна числу атомов примеси, введенных в кристалл через единичную поверхность за все время диффузии. Ее можно найти из первого закона Фика:
 .
.
Интегрируя это выражение по времени, получим:
 .
.
Случай 2. Диффузия из ограниченного источника. В этом случае остается постоянным общее количество примеси, введенное в тонкий приповерхностный слой кристалла, т. е.
 =conct;
=conct;  .
.
Решением уравнения диффузии в этом случае будет функция Гаусса:
 .
.
Профили распределения примеси для этого случая показаны на рис.2.2. Здесь же пунктиром показана концентрация исходной примеси и глубина залегания p-n – перехода. Заштрихованный прямоугольник определяет дозу легирования N.
Глубину залегания p-n – перехода можно рассчитывать по формуле:
 .
.
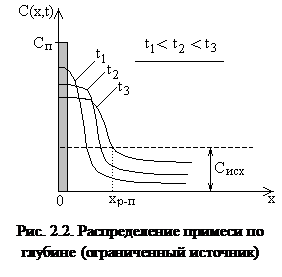 Существенное влияние на скорость диффузии кроме температуры оказывают атомы примеси и другие дефекты, присутствующие в кристалле. Локальная деформация решетки вблизи примесного атома приводит к уменьшению энергии связи между соседними атомами, что увеличивает вероятность образования вакансий. При вакансионном механизме диффузии это приводит к увеличению скорости диффузии. Энергия активации процесса диффузии может изменяться также вследствие кулоновского взаимодействия между атомами диффузианта и присутствующей в решетке примеси. Так наличие акцепторной примеси в кристалле ускоряет, а наличие донорской примеси замедляет процесс диффузии донорных атомов.
Существенное влияние на скорость диффузии кроме температуры оказывают атомы примеси и другие дефекты, присутствующие в кристалле. Локальная деформация решетки вблизи примесного атома приводит к уменьшению энергии связи между соседними атомами, что увеличивает вероятность образования вакансий. При вакансионном механизме диффузии это приводит к увеличению скорости диффузии. Энергия активации процесса диффузии может изменяться также вследствие кулоновского взаимодействия между атомами диффузианта и присутствующей в решетке примеси. Так наличие акцепторной примеси в кристалле ускоряет, а наличие донорской примеси замедляет процесс диффузии донорных атомов.
На скорость диффузии может оказать влияние и концентрация самой диффундирующей примеси. Это объясняется тем, что примесные атомы в процессе диффузии находятся в ионизированном состоянии. Возникающие при этом носители заряда (электроны в случае диффузии доноров), являясь более подвижными, чем ионы примеси, диффундируя вглубь подложки, создают электрическое поле, увлекая тем самым за собой ионы примеси. Этот дополнительный дрейф, увеличивающий эффективный коэффициент диффузии, проявляется лишь тогда, когда концентрация примеси существенно превышает собственную концентрацию носителей заряда в полупроводнике.
Задание
1. Построить профиль распределения примеси и определить глубину залегания р-n-перехода в случае двухстадийной диффузии.
 = 1000 °С
= 1000 °С
2. В случае диффузии из ограниченного источника рассчитать глубину залегания p-n – перехода и сравнить это значение с полученным из графика.
Примечание. 1. Исходная концентрация примеси в объеме кристалла 
Контрольные вопросы
1. Закономерности процесса диффузии (Законы Фика).
2. Механизмы диффузии в полупроводниках. Объяснить зависимость коэффициента диффузии от температуры.
3. Диффузия из ограниченного и неограниченного источников.
4. Влияние примеси и структурных дефектов на скорость диффузии.
5. Что называется диффузией?
6. Коэффициент диффузии и энергия активации.
7. Параметры, влияющие на скорость диффузии.
8. Диффузия из постоянного источника.
9. Диффузия из бесконечно тонкого слоя.
10 Применение диффузии для создания р-n – переходов
Литература
Томилин В.И. Физико–химические основы технологии электронных средств. М.:Академия, 2010.-410с
2. Готра З. Ю. Технология микроэлектронных устройств. Справочник. – М.,: Радио и связь, 1991. – С. 149-172.
 , мин , мин | |||||
 , мин , мин | |||||
 , мин , мин |
 - время загонки примеси,
- время загонки примеси,
 - время разгонки примеси,
- время разгонки примеси,
 - температура разгонки примеси.
- температура разгонки примеси.
Таблица П.2
Параметры диффузии примесей в кремнии
| Элемент |  |  |   |
| As |  | 3,6 |  |
| B |  | 3,7 |  |
| P |  | 3,7 |  |
| Ga |  | 4,1 |  |
| Sb |  | 3,9 |  |
| Al |  | 3,3 |  |
Примечание:
 - энергия активации,
- энергия активации,  - предельная растворимость примесей в кремнии,
- предельная растворимость примесей в кремнии,  .
.
k - постоянная Больцмана, T - температура процесса в Кельвинах.
K=8,617 343(15)×10−5 (эВ∙ К-1)
 2015-05-10
2015-05-10 4365
4365