Стандартная фотолитография. Для стандартной фотолитографии применяют фоторезисты, чувствительные к ультрафиолетовому (УФ) излучению с длиной волны от 310 до 450 нм.
Фоторезисты представляют собой сложные полимерные композиции, в составе которых имеются фоточувствительные и пленкообразующие компоненты, растворители и специальные добавки. Последние вводят для улучшения условий пленкообразования (разбавители), изменения фоточувствительности (сенсибилизаторы), повышения адгезии фоторезистивного слоя к подложкам, улучшения стойкости к воздействиям кислот, щелочей, высоких температур и др.
Фотохимические процессы, происходящие в фоторезистах под действием УФ-излучения, можно разделить на две стадии. На световой стадии в результате поглощения кванта излучения наиболее слабая химическая связь фоточувствительной молекулы разрывается и образуется свободный радикал. На темновой стадии протекают реакции, приводящие к деструкции (разрушению) молекулярных цепей полимера либо, наоборот, к структурированию (сшиванию) молекул в прочную сетку. В результате этого слой облученных участков к воздействию проявителя уменьшает или возрастает.
Молекула позитивного фоторезиста имеет строение R1–O–R2, где R1 и R2 – светочувствительная и полимерная части, О – соединяющий их атом кислорода. При поглощении квантов облучения молекула распадается на азот и неустойчивый радикал:

Облученные участки фотослоя, в отличие от необлученных удаляются щелочными проявителями.
Негативные фоторезисты изготавливают на основе поливинилциннамата (ПВЦ) или на основе каучуков. ПВЦ представляет собой сложный эфир и имеет общую формулу R1–O–R2, где R1– фоточувствительная группа; R2 – пленкообразующая часть спирта; О – соединяющий их атом кислорода. При поглощении квантов излучения наиболее слабые в светочувствительных частях молекул химические связи СН=СН разрываются. За счет освободившихся связей происходит фотоструктурирование, т. е. поперечное сшивание молекул ПВЦ в трехмерную сетку.
Негативные фоторезисты на основе каучука наиболее часто представляют собой механическую смесь циклокаучука и бис-азида. Циклокаучук является полимерной основой и обладает слабой фоточувстви-тельностью. Под действием облучения азиды распадаются на азот и нитрен. Нитрен вступает в химическое взаимодействие с каучуком, в результате которого происходит сшивание линейных полимеров каучука радикалами.
Фотошаблоны являются основными инструментами ФЛГ, с их помощью производится облучение фотослоя в соответствии с топологией микросхемы.
ФШ для изготовления структур микросхем – плоскопараллельная пластина (или гибкая пленка) из прозрачного для УФ-излучения материала с нанесенным на ее рабочую поверхность непрозрачным пленочным рисунком, соответствующим топологии одного из слоев структуры микросхемы и многократно повторенным со строго определенным шагом в пределах рабочей области пластины (или пленки).
Для основы ФШ применяют оптическое БСС или полимерные пленки, которые не изменяют свойств под действием излучения. Для выполнения рисунка применяют галоидно-серебряную фотографическую эмульсию (эмульсионные ФШ), металлы (металлизированные ФШ) и полупрозрачные для видимого света оксиды или другие материалы (транспарентные, цветные фотошаблоны).
Материал рисунка – Cr (d =0,1 мкм), Fe2O3, VO3, Eu2O3. Общие требования – хорошая адгезия, износоустойчивость, малое отражение излучения от поверхности ФШ. Для этого, например, на слой Cr наносят пленку CrхOу.
Изготовление фотошаблона с помощью увеличенного оригинала с последующим фотографическим уменьшением в несколько этапов не позволяет переносить изображения элементов размером менее 5 мкм.
В последнее время используют формирование элементов рисунка электронным пучком на стеклянном шаблоне, покрытом такими материалами, как оксиды железа, хрома или кремния. Эти ФШ обладают разрешением 1 мкм. При уменьшении размеров используют фазоповорачивающее покрытие (рис. 9.4)
Подготовка подложек к нанесению ФР определяется материалом подложки, технологией его получения, состоянием поверхности и дальнейшим назначением фотомаски. Под подложкой в литографических процессах подразумевают тот материал, на котором формируют резистивный слой. В производстве, например, полупроводниковых ИМ фотолитографию проводят по монокристаллическому и поликристаллическому кремнию, пленкам диоксида кремния, примесносиликатных стекол, алюминия и т. п.
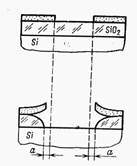 | Если фотомаска используется для локального травления, то качество передачи рисунка на подложку (например, пленку SiO2) зависит в основном от адгезии маски к подложке и от способности травителя проникать под слой фотомаски по границам окон (рис.9.3). |
| Рис. 9.3. Клин травления а при передаче рисунка с фотомаски на пленку SiO2 |
 2014-02-09
2014-02-09 1275
1275