Создание полупроводниковых ИС начинается с получения монокристаллических слит-ков кремния или германия. Обычно для этого используются метод Чохральского и метод зонной плавки.
 При методе Чохральского монокристаллические слитки полупроводника получают пу-тем кристаллизации из расплава. При этом методе стержень с затравкой (в виде монокристалла кремния) после соприкосновения с расплавом мед-ленно поднимают с одновременным вращением. При этом вслед за затрав-кой вытягивается нарастающий и застывающий слиток. Метод обеспечи-вает получение полупроводникового материала в форме совершенных мо-нокристаллов с определенной кристаллической ориентацией и минималь-ным числом дефектов. Нагреватель может быть резистивным, высокочас-тотным, электронно-лучевым.
При методе Чохральского монокристаллические слитки полупроводника получают пу-тем кристаллизации из расплава. При этом методе стержень с затравкой (в виде монокристалла кремния) после соприкосновения с расплавом мед-ленно поднимают с одновременным вращением. При этом вслед за затрав-кой вытягивается нарастающий и застывающий слиток. Метод обеспечи-вает получение полупроводникового материала в форме совершенных мо-нокристаллов с определенной кристаллической ориентацией и минималь-ным числом дефектов. Нагреватель может быть резистивным, высокочас-тотным, электронно-лучевым.
 Метод зонной плавки (метод перекристаллизации) является безти-гельным. Перед началом кристаллизации расплавляется не вся твердая фаза кристалла, а только узкая зона, которую перемещают вдоль кристалла смещением нагре-вателя. Большинство примесей обладают хорошей раст-воримостью в жидкой фазе по сравнению с твердой, поэтому по мере прод-вижения зона плавления все больше насыщается примесями, которые кон-центрируются на конце слитка. Обычно процесс зонной плавки повторяют несколько раз, по окончании очистки загрязненный конец слитка отрезают.
Метод зонной плавки (метод перекристаллизации) является безти-гельным. Перед началом кристаллизации расплавляется не вся твердая фаза кристалла, а только узкая зона, которую перемещают вдоль кристалла смещением нагре-вателя. Большинство примесей обладают хорошей раст-воримостью в жидкой фазе по сравнению с твердой, поэтому по мере прод-вижения зона плавления все больше насыщается примесями, которые кон-центрируются на конце слитка. Обычно процесс зонной плавки повторяют несколько раз, по окончании очистки загрязненный конец слитка отрезают.
Типовой диаметр слитков составляет в настоящее время 150 мм, а ма-ксимальный может достигать 300 мм и более. Длина слитков может дости-гать 3 м, но обычно она в несколько раз меньше.
Слитки кремния разрезают на множество тонких пластин (0,4 – 0,5мм) с помощью вра-щающихся стальных дисков с внутренней и внешней режущими кромками, армированными искусственными или природными алмазами. Применяется также резка с помощью тонкой проволоки (0,08 – 0,1 мм), совершающей возвратно-поступательное движение. Резку произ-водят вольфрамовой проволокой, покрытой тонким слоем алмазной крошки.
После резки слитков на пластины для получения параллельности сторон пластин, точ-ного соответствия заданным размерам и уменьшения глубины нарушенного слоя проводят шлифование пластин. Для шлифования применяются абразивные материалы, алмазные по-рошки, полировочные пасты.
После шлифования проводят полировку пластин, что обеспечивает снижение неровнос-тей поверхности до уровня, свойственного оптическим системам – сотые доли микрона. По-мимо механической (с помощью еще более мелкозернистых суспензий), используется хими-ческая полировка (травление), т. е. по существу растворение поверхностного слоя полупро-водника в тех или иных реактивах. Выступы и трещины на поверхности стравливаются быст-рее, чем основной материал, и в целом поверхность выравнивается.
Важным в полупроводниковой технологии является также очистка поверхности от за-грязнений органическими веществами, особенно жирами. Для этого используют органичес-кие растворители (толуол, ацетон, этиловый спирт и др.) при повышенной температуре. Тра-вление, очистка и многие другие процессы сопровождаются отмывкой пластины в деионизи-рованной воде.
Эпитаксия – процесс наращивания монокристаллических слоев на полупроводниковую подложку, при котором кристаллическая структура наращиваемого слоя повторяет кристал-лографическую ориентацию подложки. Эпитаксия обычно используется для получения тон-ких рабочих слоев однородного полупроводника на сравнительно толстых подложках, игра-ющих роль несущих конструкций. Эпитаксия позволяет выращивать монокристаллические слои любого типа электропроводности и любого удельного сопротивления на подложке, об-ладающей также любым типом электропроводности и удельным сопротивлением. Граница между эпитаксиальным слоем и подложкой не получается идеально резкой, поэтому затруд-нено создание сверхтонких (менее 1 мкм) слоев и многослойных эпитаксиальных структур. Но она позволяет получать достаточно тонкие слои (1 – 10 мкм), которые невозможно полу-чить другими средствами.
Эпитаксиальная пленка может отличаться от подложки по химическому составу. Спо-соб получения таких пленок называется гетероэпитаксией, в отличие от гомоэпитаксии, описанной выше. При гетероэпитаксии материалы пленки и подложки должны по-прежнему иметь одинаковую кристаллическую решетку. Например, можно выращивать кремниевую пленку на сапфировой подложке.
 При хлоридном процессе эпитаксии монокристаллические кремниевые пластины загру-жают в тигель «лодочку» и помещают в кварцевую трубу. Через трубу пропускают поток водорода, содержащий не-большую примесь тетрахлорида кремния SiCl4. При высокой температуре (около 12000С), которая обеспечивается высо-кочастотным нагревом тигля, на поверхности пластин про-исходит реакция SiCl4 + 2H2 → Si + 4HCl.
При хлоридном процессе эпитаксии монокристаллические кремниевые пластины загру-жают в тигель «лодочку» и помещают в кварцевую трубу. Через трубу пропускают поток водорода, содержащий не-большую примесь тетрахлорида кремния SiCl4. При высокой температуре (около 12000С), которая обеспечивается высо-кочастотным нагревом тигля, на поверхности пластин про-исходит реакция SiCl4 + 2H2 → Si + 4HCl.
В результате реакции на подложке постепенно осаж-дается слой чистого кремния, а пары HCl уносятся потоком водорода. Благодаря подбору температуры, химическая ре-акция происходит только на поверхности пластины, а не в окружающей среде.
Процесс, проходящий в потоке газа, называют газотранспортной реакцией, а основной газ (в данном случае водород), переносящий примесь в зону реакции, - газом-носителем.
Помимо газовой эпитаксии, существует жидкостная эпитаксия, при которой наращива-ние монокристаллического слоя осуществляется из жидкой фазы, т. е. из раствора, содержа-щего необходимые компоненты.
 Таким образом, эпитаксия позволя-ет выращивать монокристаллические слои любого типа проводимости и любо-го удельного сопротивления на подлож-ке, обладающей тоже любым типом и величиной проводимости.
Таким образом, эпитаксия позволя-ет выращивать монокристаллические слои любого типа проводимости и любо-го удельного сопротивления на подлож-ке, обладающей тоже любым типом и величиной проводимости.
 Термическое окисление – получаемая в этом процессе пленка двуокиси кремния SiO2 выполняет несколько важ-ных функций:
Термическое окисление – получаемая в этом процессе пленка двуокиси кремния SiO2 выполняет несколько важ-ных функций:
а) функцию защиты – пассивации поверхности и, в частности, защиты верти-кальных участков p-n-пере-ходов, выходящих на поверхность;
б) функцию маски, через окна которой вводятся необходимые примеси;
в) функцию тонкого диэлектрика под затвором МОП-транзистора.
Такие широкие возможности двуокиси кремния стали одной из причин того, что крем-ний в настоящее время является основным материалом для изготовления полупроводнико-вых ИС.
Поверхность кремния всегда покрыта собственной окисной пленкой даже при самых низких температурах, но эта пленка имеет слишком малую толщину (около 5 нм). Поэтому ее нельзя использовать для выполнения перечисленных функций. Пленки двуокиси кремния приходится получать искусственным путем.
Искусственное окисление кремния обычно осуществляется при высокой температуре (1000 – 12000С) и называется термическим окислением. Оно может быть проведено в атмо-сфере кислорода (сухое окисление) и в смеси кислорода с парами воды (влажное окисление) или просто в парах воды. Сухое окисление идет в десятки раз медленнее влажного. С умень-шением температуры на каждые 100С время окисления растет в 2 – 3 раза.
Легирование – операция введения необходимых примесей в монокристаллический по-лупроводник. Основным способом легирования является диффузия примесных атомов при высокой температуре. Широкое распространение получил и другой способ – ионное легиро-вание (имплантация).
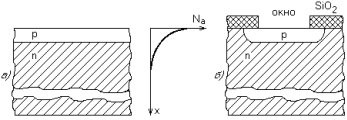 Диффузионное легирование может быть общим (по всей поверхности, рис. а) и локаль-ным (на определенных участках через окна в масках, рис. б).
Диффузионное легирование может быть общим (по всей поверхности, рис. а) и локаль-ным (на определенных участках через окна в масках, рис. б).
Общая диффузия приводит к обра-зованию в пластине тонкого диффузи-онного слоя, который отличается от эпитаксиального неоднородным (по глубине) распределением примеси.
В случае локальной диффузии примесь распространяется не только вглубь пластины, но и во всех перпендикулярных направлениях, т. е. под маску. В результате этой так называ-емой боковой диффузии участок p-n-перехода, выходящий на поверхность, оказывается “ав-томатически” защищенным окислом.
Диффузию можно проводить однократно и многократно. При проведении многократ-ной диффузии следует иметь в виду, что концентрация каждой новой вводимой примеси до-лжна превышать концентрацию предыдущей, в противном случае тип проводимости не из-менится, а значит, не образуется p-n-переход.
Ионное легирование осуществляется путем бомбардировки пластины (или эпитакси-ального слоя) ионами примеси, ускоренными до энергии, достаточной для их внедрения вглубь твердого тела.
Ионизация атомов примеси, ускорение ионов и фокусировка ионного пучка осуществ-ляется в специальных установках типа ускорителей частиц в ядерной физике. В качестве примесей используются те же материалы, что и при диффузии.
Ионная имплантация так же, как диффузия, может быть общей и локальной (избира-тельной). В последнем, более типичном случае, облучение (бомбардировка) производится через маски, в которых длина пробега ионов должна быть значительно меньше, чем в крем-нии. Важным достоинством ионной имплантации является то, что ионы, двигаясь по прямой линии, внедряются только вглубь пластины, а аналогия боковой диффузии (под маску) пра-ктически отсутствует.
Главным преимуществом ионной имплантации являются: низкая температура процесс-са и его хорошая контролируемость. Низкая температура обеспечивает возможность прове-дения ионного легирования на любом этапе технологического цикла, не вызывая при этом дополнительной диффузии примесей в ранее изготовленных слоях.
Травление в общем случае можно рассматривать как не механические способы измене-ния рельефа поверхности твердого тела.
Химическое травление подразделяется на изотропное, анизотропное и селективное. Изотропное травление – это растворение полупроводникового материала с одинаковой ско-ростью по всем кристаллографическим направлениям. Такое травление позволяет равномер-но стравливать тонкие слои и получать ровную поверхность. Такое травление называют так-же полирующим или химическим полированием. Анизотропное травление – растворение полупроводникового материала с неодинаковой скоростью по различным кристаллографи-ческим направлениям, которое позволяет вытравливать глубокие канавки и щели. Селекти-вное (избирательное) травление – растворение полупроводникового материала с повышен-ной скоростью травления в местах выхода на поверхность структурных дефектов.
Характерной особенностью локального травления (через защит-ную маску) является так называемое подтравливание – эффект, анало-гичный боковой диффузии. Он выражается в том, что травление идет не только вглубь пластины, но и в стороны – под маску. В результате стенки вытравленного рельефа оказываются не совсем вертикальными, а площадь углубления – больше площади окна в маске.
Электролитическое травление отличается тем, что химическая реакция жидкости с твердым телом и образование растворимого соединения происходят в условиях протекания тока через жидкость, причем твердое тело играет роль одного из электродов – анода. Зна-чит, твердое тело в данном случае должно обладать достаточной электропроводностью, что, конечно, ограничивает круг используемых материалов. Преимуществом электролитическо-го травления является возможность регулировать скорость травления путем изменения тока в цепи и прекращать процесс путем его отключения.
При ионном травлении пластина кремния помещается в разреженное пространство, в котором, невдалеке от пластины, создается тлеющий разряд. Пространство тлеющего разря-да заполнено квазинейтральной электронно-ионной плазмой. На пластину относительно плазмы подается достаточно большой отрицательный потенциал. В результате положитель-ные ионы плазмы бомбардируют поверхность пластины и слой за слоем выбивают атомы с поверхности, т. е. травят ее. Причем напряжение в этом случае значительно меньше ускоря-ющих напряжений при ионной имплантации, поэтому внедрение ионов в пластину не про-исходит. Аналогичным способом достигается очистка поверхности от загрязнений – ионная очистка.
Преимуществом локального ионного травления является отсутствие “подтравливания” под маску: стенки вытравленного рельефа практически вертикальны, а площади углублений равны площади окон в маске.
Общее преимущество ионного травления заключается в его универсальности (не тре-буется индивидуального кропотливого подбора травителей для каждого материала), а об-щий недостаток – необходимость дорогостоящих установок и значительных затрат времени на создание в них нужного вакуума.
Литография – процесс формирования отверстий в масках, применяемых для локаль-ной диффузии, травления, окисления и других операций. Существует несколько разновид-ностей этого процесса.
Фотолитография основана на использовании светочувствительных материалов фото-резистов (ФР), которые могут быть позитивными и негативными. Негативные фоторезисты под действием света полимеризуются и становятся устойчивыми к травителям. В позитив-ных фоторезистах свет, наоборот, разрушает полимерные цепочки, поэтому засвеченные участки фоторезиста разрушаются травителем. При производстве полупроводниковых ИС слой фоторезиста наносят на поверхность двуокиси кремния, а при производстве гибридных ИС – на тонкий слой металла, нанесенный на подложку, или на тонкую металлическую пла-стину, выполняющую функции съемной маски. Необходимый рисунок элементов ИС полу-чают путем облучения фоторезиста светом через фотошаблон (ФШ), представляющий со-бой стеклянную пластину, на одной из сторон которой имеется позитивный или негативный  рисунок элементов ИС в масштабе 1:1 (рис. а). При производстве ИС использу-ется несколько фотошабло-нов, каждый из которых за-дает рисунок тех или иных слоев (базовых и эмиттер-ных областей, контактных выводов и т. д.). После облучения светом неполимеризованные участки фоторезиста удаля-ются травителем и на поверхности двуокиси кремния (или металлической пленки) образует-ся фоторезистивная маска (рис. б), через отверстия в которой осуществляется травление SiO2 (или металлической пленки), в результате рисунок фотошаблона оказывается перене-сенным на поверхность подложки (рис. в). Созданию фотошаблонов предшествует тополо-гическое проектирование микросхемы, результатом которого является получение в увели-ченном масштабе (100:1; 200:1; 500:1 или 1000:1) послойных топологических чертежей – фотооригиналов, вычерчиваемых с помощью специальных устройств – координатографов, работающих в автоматическом режиме в соответствии с программой, задаваемой ЭВМ. Следующим этапом является фотографирование оригинала с уменьшением в 20-50 раз, за-тем второе фотографирование с уменьшением и мультиплицированием (размножением) ри-сунка. В итоге получают эталонный фотошаблон с матрицей одинаковых рисунков в мас-штабе 1:1. С эталонного шаблона методом контактной печати изготавливают рабочие фото-шаблоны.
рисунок элементов ИС в масштабе 1:1 (рис. а). При производстве ИС использу-ется несколько фотошабло-нов, каждый из которых за-дает рисунок тех или иных слоев (базовых и эмиттер-ных областей, контактных выводов и т. д.). После облучения светом неполимеризованные участки фоторезиста удаля-ются травителем и на поверхности двуокиси кремния (или металлической пленки) образует-ся фоторезистивная маска (рис. б), через отверстия в которой осуществляется травление SiO2 (или металлической пленки), в результате рисунок фотошаблона оказывается перене-сенным на поверхность подложки (рис. в). Созданию фотошаблонов предшествует тополо-гическое проектирование микросхемы, результатом которого является получение в увели-ченном масштабе (100:1; 200:1; 500:1 или 1000:1) послойных топологических чертежей – фотооригиналов, вычерчиваемых с помощью специальных устройств – координатографов, работающих в автоматическом режиме в соответствии с программой, задаваемой ЭВМ. Следующим этапом является фотографирование оригинала с уменьшением в 20-50 раз, за-тем второе фотографирование с уменьшением и мультиплицированием (размножением) ри-сунка. В итоге получают эталонный фотошаблон с матрицей одинаковых рисунков в мас-штабе 1:1. С эталонного шаблона методом контактной печати изготавливают рабочие фото-шаблоны.
Важным параметром фотолитографии является разрешающая способность, характери-зуемая максимальным числом раздельно воспроизводимых параллельных линий в маске в пределах 1 мм. На практике разрешающую способность определяют минимальной шириной линии Δ. Принципиальным физическим фактором, ограничивающим Δ, является дифракция света, не позволяющая получить Δ меньше длины волны (для видимого света λ ≈ 0,5 мкм). Практически методом фотолитографии можно получить Δ ≈ 1 мкм. Таким образом, мини-мальный размер элемента ИС не может быть меньше Δ.
Рентгеновская литография использует мягкое рентгеновское излучение с длиной вол-ны около 1 нм, что позволяет получить Δ ≈ 0,1 мкм. Фотошаблон в этом случае представляет собой тонкую мембрану (около 5 мкм), прозрачную для рентгеновских лучей, на которой ме-тодом электронно-лучевой литографии создан рисунок элементов ИС.
Электронно-лучевая литография использует облучение электронорезиста сфокусиро-ванным потоком электронов. Перемещаясь по поверхности пластины, включаясь и выключа-ясь по заданной программе, электронный луч создает необходимый рисунок элементов ИС. Минимальный размер элемента Δ ≈ 0,1-0,2 мкм. Он ограничен минимальным диаметром эле-ктронного луча. Этот вид литографии используется в основном для изготовления рентгено-шаблонов.
Ионно-лучевая литография использует облучение резиста пучком ионов. Чувствитель-ность резиста к ионному облучению во много раз выше, чем к электронному, что позволяет использовать пучки с малыми токами и малым диаметром (до 0,01 мкм). Система ионно-лу-чевой литографии технологически совместима с установками ионного легирования[1, 3].
 2015-02-27
2015-02-27 961
961








