На подложке р-типа формируется эпитаксиальный слой n-типа (рисунок 4.4а). Затем проводится термическое окисление (рисунок 4.4б), и методом фотолитографии формируются окна под разделительную диффузию, т.е. маска из слоя SiO2 остается на тех местах, где будут изготовляться биполярные транзисторы и другие элементы схемы (рисунок 4.4в).
Следующим этапом проводится разделительная диффузия акцепторной примесью (рисунок 4.4в) так, чтобы атомы примеси достигли подложки под эпитаксиальным слоем и в результате получается, что элементы схемы будут отделены друг от друга полупроводником р-типа.
Проводится второе термическое окисление, вторая фотолитография и вторая диффузия акцепторной примесью с тем, чтобы сформировать базовый слой транзистора (рисунок 4.4г). Эта диффузия требует меньшее время, так как глубина базового слоя 2,5-2,7 мкм меньше, чем при разделительной диффузии.
Затем проводятся ещё одно термическое окисление, фотолитография, при которой вскрываются окна под эмиттерную область и вывод коллектора, и проводится последняя диффузия донорной примесью (рисунок 4.4д). В этих областях создается максимальная концентрация примеси. Глубина n+- слоев составляет примерно 2 мкм. Максимальная концентрация примеси в месте вывода коллектора исключает появление выпрямляющего контакта металл-полупроводник (диод Шоттки).
После четвертого заключительного термического окисления и ещё одной фотолитографии вскрываются окна для межэлементных соединений металлической пленкой (рисунок 4.4е).
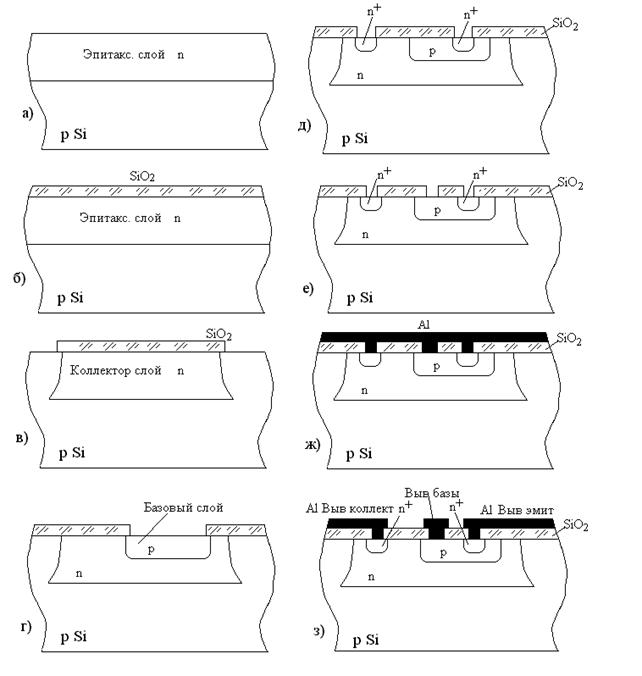
Рисунок 4.4
В результате термического напыления получается сплошная пленка алюминия (рисунок 4.4ж).
На заключительном этапе проводится последняя фотолитография, при которой из пленки Al формируются межэлементные соединения (рисунок 4.4з). Вид на транзистор в плане с размерами показан на рисунке 4.5.
Таким образом, в процессе формирования транзистора использовались: пять фотолитографий, четыре термических окисления, три процесса диффузии, по одному процессу эпитаксии и термическому напылению алюминия не считая ряда вспомогательных операций: очистка, промывка, удаление фоторезиста и т.д.
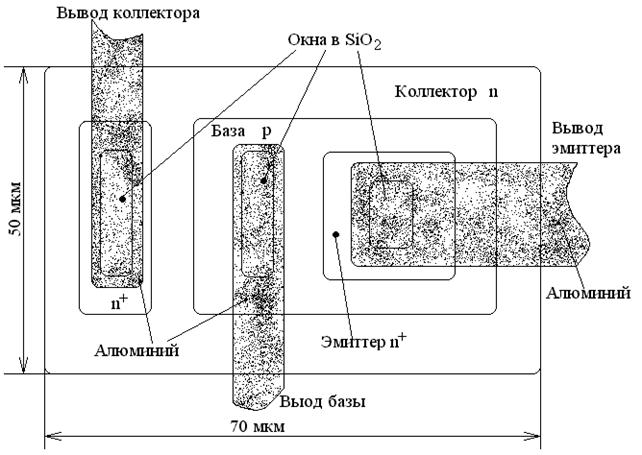 Рисунок 4.5
Рисунок 4.5
 2015-04-01
2015-04-01 443
443








