В полупроводниковых ИС все элементы выполнены внутри (в приповерхностном слое) и на поверхности полупроводниковой подложки, называемой кристаллом, которая представляет собой пластинку кремния толщиной 200 – 300 мкм. Площадь кристалла бывает обычно от 1,5 × 1,5 до 6 × 6 мм. По сравнению с пленочными и гибридными ИС полупроводниковые микросхемы имеют наиболее высокое число элементов в единице объема и наибольшую надежность (наименьшую интенсивность отказов). Недостаток полупроводниковых ИС – несколько худшее качество пассивных элементов (резисторы и конденсаторы) и невозможность создания в полупроводнике катушек индуктивности. Тем не менее на основе полупроводниковых ИС делаются большие и сверхбольшие ИС, используемые в микроэлектронике.
Изоляция. Поскольку все элементы делаются в едином полупроводниковом кристалле, то важно обеспечить изоляцию элементов от кристалла и друг от друга. Применяется несколько способов изоляции. Наиболее простой и дешевой является изоляция п – р -переходом. В этом случае в кристалле, например из кремния типа р, методом диффузии делаются области типа п, называемые «карманами» (рис.3 а). В «карманах» затем формируются необходимые пассивные или активные элементы, а п – р -переход между «карманом» и кристаллом в работающей ИС постоянно находится под обратным напряжением. Для этого на кристалл постоянно подается отрицательный потенциал в несколько вольт. Кремниевый п – р -переход при обратном напряжении имеет очень высокое сопротивление (несколько мегаом), которое и выполняет роль изоляции. Очевидно, что между любыми двумя элементами сопротивление изоляции будет равно двойному обратному сопротивлению изолирующего п – р -перехода. Следует учитывать, что каждый такой переход имеет барьерную емкость, и поэтому между элементами возникает паразитная емкостная связь через емкости переходов.
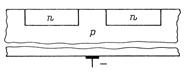
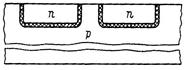
а б
Рис.3. а – изоляция элементов n – p -переходом, б – изоляция элементов диэлектрическим слоем
Второй вид изоляции – диэлектрическим слоем – показан на рис.3 б. Здесь также имеются «карманы» для последующего формирования в них нужных элементов, но между «карманом» и кремниевым кристаллом имеется тонкий диэлектрический слой диоксида кремния SiO2. Создание этого слоя значительно усложняет изготовление микросхемы. Но зато изоляция получается значительно лучше, чем п – р- переходом. И паразитная емкость между «карманом» и кристаллом при этом методе изоляции гораздо меньше, так как диэлектрический слой в несколько раз толще изолирующего n – p -перехода. Однако из-за технологической сложности изоляции диэлектрическим слоем чаще всего применяется изоляция n – p - переходом. В дальнейшем изложении везде на рисунках показана именно такая изоляция.
Представляет интерес еще так называемая изопланарная технология создания изоляции, иначе называемая комбинированной. В этом случае боковые стороны «карманов» изолированы диэлектрическим слоем диоксида кремния, а нижняя сторона изолирована от подложки п – р -переходом под обратным напряжением (рис.3. б). При таком методе паразитная емкость между элементами несколько меньше, чем при изоляции только п – р- переходом, и достигается большая плотность размещения элементов, так как промежутки между элементами значительно уменьшаются.
Биполярные транзисторы. Они делаются по пленарной или планарно-эпитаксиальной технологии. Методом диффузии в кристалле создаются области коллектора, базы и эмиттера (рис.4). На рисунке транзистор показан в разрезе и в плане. Структура транзистора углубляется в кристалл не более чем на 15 мкм, а линейные размеры транзистора на поверхности не превышают нескольких десятков микрометров.
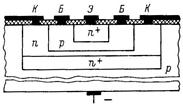
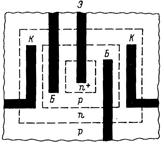
Рис.4. Биполярный транзистор типа n – p – n
Как правило, изготовляются транзисторы типа п – р – п. Внутренний (скрытый) слой с повышенной концентрацией примесей п+ в коллекторе служит для уменьшения сопротивления и, следовательно, потерь мощности в области коллектора. Но у коллекторного перехода область коллектора должна иметь пониженную концентрацию примесей, чтобы переход имел большую толщину. Тогда емкость у него будет меньше, а напряжение пробоя выше. Область эмиттера также часто делают типа п+ для уменьшения сопротивления и увеличения инжекции. Сверху на транзисторе создается защитный слой оксида SiO2. От областей коллектора и базы часто делают по два вывода (рис.4), для того чтобы можно было соединить данный транзистор с соседними элементами без пересечений соединительных линий. Такие пересечения весьма нежелательны, так как они значительно усложняют производство. Действительно, в месте пересечения надо на нижнюю соединительную линию нанести диэлектрическую пленку, а поверх нее нанести верхнюю соединительную линию, т. е. надо сделать две лишние технологические операции. Кроме того, место пересечения всегда представляет опасность в отношении пробоя от случайных перенапряжений.
Важная проблема при проектировании и конструировании ИС – такое размещение (топология) элементов схемы, при котором соединения могут быть сделаны без пересечений или, в крайнем случае, с минимальным числом пересечений. При большом числе элементов может быть огромное число вариантов их размещения, и для рассмотрения всех таких вариантов с целью выбора оптимального надо затратить очень много времени. В последнее время эту работу стали выполнять электронно-вычислительные машины, которые, действуя по определенным заданным условиям, в короткое время могут выбрать наивыгоднейший вариант размещения элементов.
Необходимо обратить внимание на то, что в полупроводниковых ИС всегда образуются некоторые паразитные элементы. Например, из рис.4 видно, что наряду с транзистором типа п – р – п, созданным в кристалле типа р, существует паразитный транзистор р – п – р, который образуется кристаллом, областью коллектора и областью базы транзистора. А транзистор п – р – п вместе с кристаллом образует паразитный тиристор п – р – п – р. Вследствие наличия обратного напряжения на изолирующем переходе паразитные транзисторы и тиристор нормально заперты, но при попадании в них каких-либо импульсов помех может произойти нежелательное отпирание и срабатывание этих элементов.
Диоды (транзисторы в диодном включении). Ранее диоды ИС выполнялись в виде структуры из двух областей с различным типом электропроводности, т.е. в виде обычного п – р -перехода. В последние годы в качестве диодов стали применяться биполярные транзисторы в диодном включении. Возможны пять вариантов диодного включения транзистора. Они показаны на рис. 5 и несколько отличаются друг от друга параметрами. В варианте БК – Э замкнуты накоротко база и коллектор. У такого диода время восстановления, т. е. время переключения из открытого состояния в закрытое, наименьшее – единицы наносекунд. В варианте Б – Э используется только эмиттерный переход. Время переключения в этом случае в несколько раз больше. Оба этих варианта имеют минимальную емкость (десятые доли пикофарада) и минимальный обратный ток (0,5 – 1,0 нА), однако и минимальное пробивное напряжение.
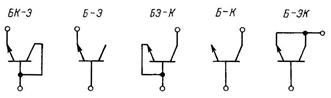
Рис.5. Варианты использования транзисторов в качестве диодов
Вариант БЭ – К, в котором закорочены база и эмиттер, и вариант Б – К (с использованием одного коллекторного перехода) по времени переключения и емкости примерно равноценны варианту Б –Э, но имеют более высокое пробивное напряжение (40 – 50 В) и больший обратный ток (15 – 30 нА). Вариант Б – ЭК с параллельным соединением обоих переходов имеет наибольшее время переключения (100 нс), наибольший обратный ток (до 40 нА), несколько большую емкость и такое же малое пробивное напряжение, как и в первых двух вариантах. Чаще всего используются варианты БК – Э и Б – Э.
Полевые транзисторы с п – р -переходом. Эти транзисторы могут быть изготовлены совместно с биполярными – на одном кристалле. На рис. 6, а показана структура планарного полевого транзистора с n -каналом. В «кармане» n -типа созданы области (n + -типа) стока и истока и область (р -типа) затвора. Сток расположен в центре, затвор вокруг него. Для уменьшения начальной толщины канала иногда внутри делают скрытый слой р +,но это связано с усложнением технологических процессов. Другой вариант полевого транзистора – с каналом р -типа – изображен на рис. 6, б. Его структура совпадает со структурой обычного п – р – n -транзистора. В качестве канала используется слой базы.


а б
Рис. 6. Полевой транзистор полупроводниковой ИС с каналом
n -типа (а) и p -типа (б)
МОП-транзисторы. Биполярные транзисторы в ИС все больше вытесняются транзисторами типа МОП (или МДП). Это объясняется важными преимуществами МОП-транзисторов, в частности их высоким входным сопротивлением и простотой устройства. Особенно просто изготовляются МОП-транзисторы с индуцированным каналом. Для них в кристалле р -типа надо лишь создать методом диффузии области п + истока и стока (рис. 7, а). На переходах между этими областями и подложкой поддерживается обратное напряжение, и таким образом осуществляется изоляция транзисторов от кристалла и друг от друга. Аналогична изоляция канала от кристалла.

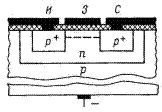
а б
Рис. 7. МОП-транзистор полупроводниковой ИС с индуцированным каналом n -типа (а) и p -типа (б)
Несколько сложнее изготовление на подложке типа р МОП-транзистора с каналом р -типа, так как для подобного транзистора необходимо сначала сделать «карман» n -типа (рис. 7, б). В некоторых ИС находят применение пары МОП-транзисторов с каналами п- и р -типа. Такие пары называют комплементарными транзисторами (КМОП или КМДП). Комплементарные транзисторы применяются в ключевых (цифровых) схемах и отличаются очень малым потреблением тока и высоким быстродействием. Встречаются также ИС, в которых на одном общем кристалле изготовлены биполярные и МОП-транзисторы.
Технология изготовления МОП-транзисторов непрерывно совершенствуется, и в настоящее время существует несколько различных типов структур таких транзисторов. Однако основной принцип их работы не меняется.
Резисторы. Вполупроводниковых ИС используются так называемые диффузионные резисторы, представляющие собой созданные внутри кристалла области с тем или иным типом электропроводности. На рис. 8 показаны структуры таких резисторов. Сопротивление диффузионного резистора зависит от длины, ширины и толщины области, выполняющей роль резистора, и от удельного сопротивления, т. е. от концентрации примесей. Резистор типа р (рис. 8, а)делается одновременно с базами транзисторов. В этом случае удельное сопротивление составит сотни ом на квадрат и могут быть получены номиналы до десятков килоом. Для увеличения сопротивления иногда резистор делают зигзагообразной конфигурации. Если необходимы относительно малые сопротивления (единицы и десятки ом), то резисторы изготовляют одновременно с эмиттерными областями типа п (рис. 8, б) транзисторов. Температурный коэффициент диффузионных полупроводниковых резисторов получается равным десятым долям процента на кельвин и менее. Допуск (отклонение от номинала) составляет ± (15 – 20)%.

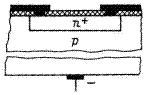
а б
Рис.8. Диффузионные резисторы полупроводниковых ИС
В последнее время помимо метода диффузии для изготовления резисторов ИС стали применять метод ионной имплантации. Он состоит в том, что соответствующее место кристалла подвергается бомбардировке ионами примеси, которые проникают в кристалл на глубину 0,2 – 0,3 мкм. У таких ионно-легированных резисторов удельное сопротивление может быть до 20 kOm/□ а номиналы достигают сотен килоом с допуском ± (5 – 10)%.
В качестве резистора может быть использован канал МОП-структуры. Такие МОП-резисторы делаются одновременно с МОП-транзисторами. Если по структуре они изготовлены аналогично транзисторам, то подбором напряжения затвора можно установить нужное сопротивление резистора. Аналогичны МОП-резисторам так называемые пинч-резисторы, имеющие структуру полевого транзистора с п – р -переходом. Резистором служит канал, а нужное сопротивление подбирается напряжением затвора.
Конденсаторы. Типичным для полупроводниковых ИС является диффузионный конденсатор, в котором используется барьерная емкость n – р -перехода. Емкость такого конденсатора (рис. 9) зависит от площади перехода, диэлектрической проницаемости полупроводника и толщины перехода, которая, в свою очередь, зависит от концентрации примесей. Если нужна большая емкость, то переход делают одновременно с эмиттерными переходами транзисторов. Так как область эмиттера имеет электропроводность n + -типа, то переход в конденсаторе будет более тонким; удельная емкость получится больше, примерно 1000 пФ/мм2. В этом случае конденсаторы делаются емкостью до 1500 пФ с допуском ±20%. Температурный коэффициент емкости (ТКЕ) составляет примерно – 10 – 3 К – 1, пробивное напряжение не превышает 10 В. У конденсаторов, изготовленных одновременно с коллекторными переходами, удельная емкость будет меньше, примерно 150 пФ/мм2. Такие конденсаторы имеют емкость не более 500 пФ с допуском ±20%. Пробивное напряжение у них до 50 В, ТКЕ равен – 10 – 3 К – 1.
Диффузионные конденсаторы работают только при обратном напряжении, которое должно быть постоянным для получения постоянной емкости. Так как барьерная емкость нелинейна, то диффузионный конденсатор может работать в качестве конденсатора переменной емкости, регулируемой электрически – путем изменения постоянного напряжения на конденсаторе. Изменяя обратное напряжение в пределах 1 – 10 В, можно изменять емкость, в 2,0 – 2,5 раза. В некоторых схемах РЭА требуются нелинейные конденсаторы. Их функции могут выполнять диффузионные конденсаторы.
На рис. 9 изображена в разрезе часть полупроводниковой ИС, соответствующая схеме на рис. 2, т. е. состоящая из диффузионного конденсатора, транзистора и резистора.
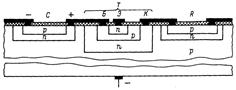
Рис. 9. Полупроводниковая ИС
Индуктивность. Катушки индуктивности в полупроводниковых ИС сделать невозможно. Поэтому обычно проектируются такие ИС, в которых не требуется индуктивность. Если все же необходимо иметь индуктивное сопротивление, то можно создать эквивалент индуктивности, состоящий из транзистора, резистора и конденсатора. Пример одного из таких эквивалентов показан на рис. 10. Здесь переменное напряжение U подводится между коллектором и эмиттером транзистора. Для упрощения не показана подача на транзистор постоянною питающего напряжения. Часть переменного напряжения U через RC -цепь подается на базу. Значения R и С подобраны так, что R >> 1/( С). Тогда ток IRC в RC -цепи можно приближенно считать совпадающим по фазе с напряжением U. Но напряжение UC на конденсаторе отстает от тока IRC на 90 °. Напряжение UC подается на базу и управляет коллекторным током транзистора I к, который совпадает по фазе с напряжением UC,т. е. отстает на 90 ° от напряжения U.
С). Тогда ток IRC в RC -цепи можно приближенно считать совпадающим по фазе с напряжением U. Но напряжение UC на конденсаторе отстает от тока IRC на 90 °. Напряжение UC подается на базу и управляет коллекторным током транзистора I к, который совпадает по фазе с напряжением UC,т. е. отстает на 90 ° от напряжения U.
Таким образом, транзистор в этой схеме создает для напряжения U сопротивление, эквивалентное некоторому индуктивному сопротивлению xL = U/I к =  L экв.Иначе говоря, транзистор эквивалентен некоторой индуктивности L экв = U / (
L экв.Иначе говоря, транзистор эквивалентен некоторой индуктивности L экв = U / ( I к).Устанавливая с помощью питающих напряжений больший или меньший ток I к, можно получать различные значения L экв.Поскольку сопротивление RC -цепи во много раз больше xL,то влиянием этой цепочки пренебрегают.
I к).Устанавливая с помощью питающих напряжений больший или меньший ток I к, можно получать различные значения L экв.Поскольку сопротивление RC -цепи во много раз больше xL,то влиянием этой цепочки пренебрегают.
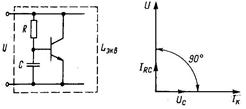
Рис.10. Эквивалент индуктивности
Принципы изготовления ИС. На рис. 11 показана упрощенно возможная технология изготовления полупроводниковых ИС. На кремниевом кристалле типа р (рис. 11, а)с тщательно отшлифованной поверхностью создается тонкий слой SiO2 (2) и на него наносится слой так называемого фоторезиста (1). Фоторезист представляет собой вещество, которое под действием облучения становится кислотостойким (или, наоборот, кислотостойкое вещество, которое под действием облучения становится растворимым в кислоте). Затем на фоторезист воздействуют ультрафиолетовыми лучами (рис. 9, б) через так называемый фотошаблон (3),представляющий собой фотопластинку с соответствующим рисунком, состоящим из прозрачных и непрозрачных участков. Такой фотошаблон получается путем фотографирования с чертежа, выполненного на бумаге. Облученные участки (4)фоторезиста становятся кислотостойкими. Далее кислотой вытравливаются слои 1 и 2 на необлученных участках. Такой метод носит название фотолитографии. На этих участках образуется «окно» (5), через которое осуществляется диффузия донорных атомов (6) из нагретого газа (рис. 9, в, г).
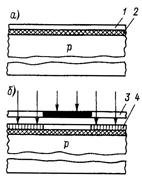
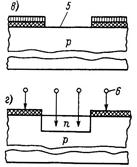
Рис.9. Схема изготовления полупроводниковой ИС
В результате в кристалле создается n -область («карман»). Фоторезист, оставшийся на облученных участках, смывается специальным растворителем. Затем все повторяется, т. е. создается на всей поверхности слой SiO2, на нем слой фоторезиста, он облучается через другой фотошаблон, и образуется «окно» меньшего размера, через которое методом диффузии акцепторных атомов внутри n -области создается р -область, и т. д.
Интегральные микросхемы могут быть изготовлены либо по биполярной технологии, т. е. па основе структур биполярных транзисторов, либо по МДП-технологии, основанной на МДП-структурах. Сравнение показывает, что МДП-технология проще и дешевле. Для создания МДП-схем требуется значительно меньше технологических операций. Схемы на МДП-структурах превосходят схемы на биполярных структурах по плотности упаковки, степени интеграции, потребляемой мощности (ниже), входному сопротивлению (выше), но уступают по быстродействию. Ведутся разработки по повышению быстродействия МДП-схем. Для этого снижают паразитные емкости, применяют каналы n -типа с примесями, способствующими увеличению подвижности носителей. Иногда применяют комбинированную технологию, в которой сочетаются биполярные и МДП-структуры.
Интегральные микросхемы характеризуются высокой надежностью. У полупроводниковых микросхем интенсивность отказов составляет 10 – 8 – 10 – 8 ч – 1 .
Полные отказы обычно происходят из-за коротких замыканий и обрывов. Короткие замыкания возникают под действием механических вибраций или ударов либо в результате перегрева и разрушения диэлектриков. Короткому замыканию способствует и попадание влаги в корпус ИС из-за каких-то дефектов герметизации. Нарушения, и в частности обрывы, контактов могут также возникать от вибраций и ударов или в результате электрохимических и химических процессов.
Постепенные отказы происходят от изменений параметров ИС. Главная причина этих изменений – возникающие на границе кремния и его диоксида процессы, связанные с перемещением ионов, которые имеются в диоксиде. Под действием электрических полей ионы дрейфуют и образуют в слое диэлектрика проводящие каналы. За счет таких паразитных каналов уменьшаются входное сопротивление и коэффициент усиления тока.
 2014-02-17
2014-02-17 7014
7014
